
Wetenschap
Studie toont de route van afzetting van atomaire lagen aan naar schaalbare dunne films van tellurium van elektronische kwaliteit
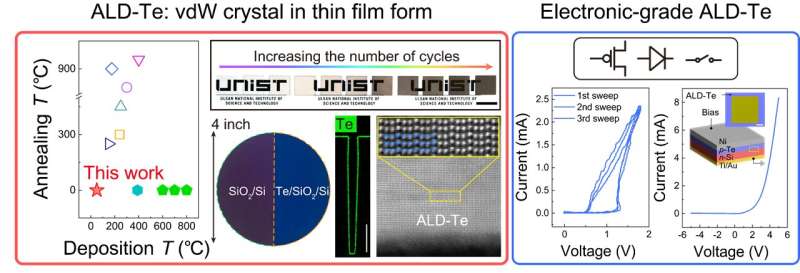
Een onderzoeksteam onder leiding van professor Joonki Suh van de afdeling Materials Science and Engineering en de Graduate School of Semiconductor Materials and Devices Engineering van UNIST heeft een belangrijke doorbraak bereikt in de technologie voor dunne-filmdepositie. Door gebruik te maken van een innovatief atomic layer deposition (ALD)-proces heeft professor Seo met succes een regelmatige rangschikking van tellurium (Te)-atomen bereikt bij lage temperaturen tot wel 50 graden Celsius.
De ALD-methode is een geavanceerd dunnefilmproces dat het nauwkeurig stapelen van halfgeleidermaterialen op atomair laagniveau op driedimensionale structuren mogelijk maakt, zelfs bij lage procestemperaturen. Traditionele toepassing op halfgeleiders van de volgende generatie vereist echter hoge verwerkingstemperaturen boven de 250 graden Celsius en aanvullende warmtebehandelingen boven de 450 graden Celsius.
In dit onderzoek heeft het UNIST-team ALD toegepast op mono-elementair van der Waals-tellurium, een materiaal dat uitgebreid wordt onderzocht vanwege de mogelijke toepassingen ervan in elektronische apparaten en thermo-elektrische materialen.
Opmerkelijk genoeg vervaardigden ze met succes dunne Te-films van hoge kwaliteit zonder enige warmtebehandeling na depositie bij een ongekend lage temperatuur van slechts 50 graden Celsius. De resulterende films vertoonden uitzonderlijke uniformiteit met nauwkeurig gecontroleerde diktes tot op nanometerschaal, waardoor een perfecte atoomrangschikking werd bereikt met één op de miljard atomen.
Om de reactiviteit bij lagere temperaturen te verbeteren, gebruikte het onderzoeksteam twee precursors met zuur-base-eigenschappen. Bovendien introduceerden ze co-reactanten om oppervlaktereacties en stabiliteit te verbeteren, terwijl ze een herhalende doseringstechniek toepasten door precursoren met kortere tussenpozen te injecteren. Deze strategieën maakten de productie van dichte en continue dunne Te-films mogelijk in vergelijking met conventionele methoden die vaak resulteerden in poreuze of discontinue korrelafzettingen.
Het ontwikkelde productieproces maakte groei op waferschaal mogelijk op volledige wafers van 4 inch (100 mm), wat een nauwkeurige controle van de dikte op atomair laagniveau en een uniforme afzetting mogelijk maakte. Bovendien toonden de dunne Te-films compatibiliteit met verticale driedimensionale structuren aan – een cruciale vereiste voor hoge apparaatintegratie. Deze doorbraak biedt een aanzienlijk potentieel voor verschillende elektronische apparaten, zoals transistors, gelijkrichters en selectie-elementen.
"Dit onderzoek voldoet aan alle essentiële criteria van synthese bij lage temperaturen, grote oppervlakken en hoge kwaliteit in halfgeleiderdepositieprocessen", aldus professor Suh.
De resultaten van dit onderzoek zijn gepubliceerd in ACS Nano .
Meer informatie: Changhwan Kim et al., Atomic Layer Deposition Route to Scalable, Electronic-Grade van der Waals Te Thin Films, ACS Nano (2023). DOI:10.1021/acsnano.3c03559
Journaalinformatie: ACS Nano
Aangeboden door Ulsan Nationaal Instituut voor Wetenschap en Technologie
 Kunnen biologisch afbreekbare vervuilers milieuproblemen veroorzaken?
Kunnen biologisch afbreekbare vervuilers milieuproblemen veroorzaken?  grillige winden, droge omstandigheden voeden dodelijke branden in Californië
grillige winden, droge omstandigheden voeden dodelijke branden in Californië Ten minste 13% van het afvalwater dat door septische systemen in Zuid-Ontario wordt behandeld, komt terecht in stromen
Ten minste 13% van het afvalwater dat door septische systemen in Zuid-Ontario wordt behandeld, komt terecht in stromen Kan zeewier gasachtige koeien op melkveebedrijven verlichten?
Kan zeewier gasachtige koeien op melkveebedrijven verlichten? Wil je de klimaatverandering aanpakken? Pak eerst je voedselverspilling aan
Wil je de klimaatverandering aanpakken? Pak eerst je voedselverspilling aan
Hoofdlijnen
- Wat is een Mordant in de microbiologie?
- Nieuwe atlas biedt ongekende inzichten over hoe genen functioneren in de vroege embryo-ontwikkeling
- Bevindingen suggereren dat ILF3 kan functioneren als een lezer van telomere R-lussen om telomere homeostase te helpen behouden
- Winden van zorg:Amerikaanse vissers zijn bang voor bossen met krachtturbines
- GoT-ChA:Nieuw hulpmiddel onthult hoe genmutaties cellen beïnvloeden
- Wat is een Gamete?
- Wat zijn de vier organische moleculen in levende dingen?
- Geven dieren bewustzijn aan?
- Hoe mechanische stimuli cellulaire signalen activeren
- Streetwear veranderen in zonne-energiecentrales

- Grafeen kan de weg vrijmaken voor Australische productie

- Een opwindende opmars naar de powersuits van morgen

- Geheimen van mysterieuze metalen hotspots ontdekt door nieuwe beeldvormingstechniek met één molecuul

- Een pagina uit de natuur om betere nanomaterialen te bouwen

 Boeing B-52 Stratofortress
Boeing B-52 Stratofortress  Zacht, sociale robot brengt gezelligheid in huis robotica
Zacht, sociale robot brengt gezelligheid in huis robotica Wetenschappers klaar om reproduceerbaarheid van Braziliaans biomedisch onderzoek te bestuderen
Wetenschappers klaar om reproduceerbaarheid van Braziliaans biomedisch onderzoek te bestuderen Sociale media voor medische tijdschriften zijn actief in het wilde westen, heeft meer ondersteuning nodig om te slagen
Sociale media voor medische tijdschriften zijn actief in het wilde westen, heeft meer ondersteuning nodig om te slagen Op fragmenten gebaseerde benaderingen gebruiken om nieuwe antibiotica te ontdekken
Op fragmenten gebaseerde benaderingen gebruiken om nieuwe antibiotica te ontdekken Nanowetenschappen:alle systemen gaan naar de biofabriek
Nanowetenschappen:alle systemen gaan naar de biofabriek Hoe u duizenden gratis films en tv-programma's kunt streamen
Hoe u duizenden gratis films en tv-programma's kunt streamen Voorgestelde transistor is gemaakt van grafeen en een tweedimensionale supergeleider
Voorgestelde transistor is gemaakt van grafeen en een tweedimensionale supergeleider
- Elektronica
- Biologie
- Zonsverduistering
- Wiskunde
- French | Italian | Spanish | Portuguese | Swedish | German | Dutch | Danish | Norway |

-
Wetenschap © https://nl.scienceaq.com

