
Wetenschap
Inspectie van optische waferdefecten bij het 10 nm-technologieknooppunt en verder
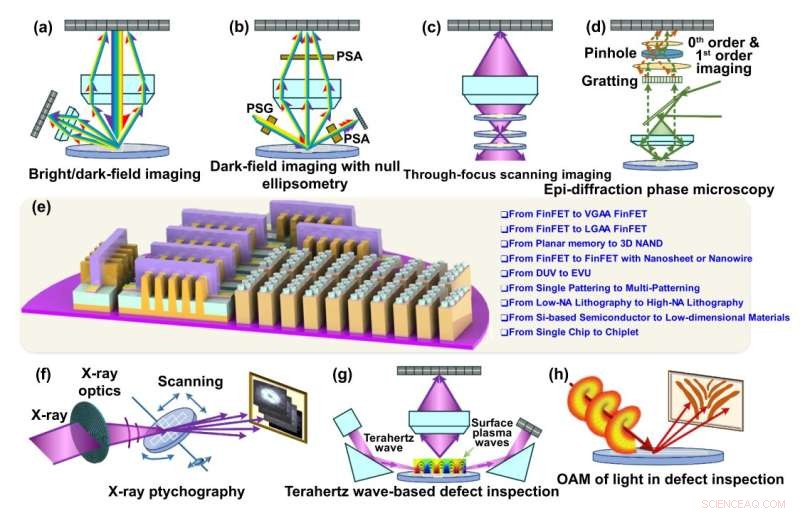
Diverse optische wafer-defectinspectiesystemen, waaronder (a) Brightfield/darkfield imaging-systeem, (b) Dark-field imaging met nul-ellipsometrie, (c) Through-focus scanning imaging microscopie, (d) Epi-diffractiefasemicroscopie, (e) Patterned wafer met logische dies en 3D NAND-geheugenstempels, (f) X-ray ptychografie, (g) THz-golfgebaseerd defectinspectiesysteem, en (h) Coherente Fourier-scatterometrietechnieken met behulp van verschillende OAM-verlichtingsstralen. Krediet:door Jinlong Zhu et al
Defectinspectiewetenschappers van Huazhong University of Science and Technology, Harbin Institute of Technology en The Chinese University of Hong Kong maken een grondige bespreking van nieuwe perspectieven en opwindende trends op basis van eerdere goede recensies op het gebied van defectinspectiemethoden. De beoordeling richt zich op drie specifieke gebieden:(1) de evaluatie van de detecteerbaarheid van defecten, (2) de diverse optische inspectiesystemen en (3) de nabewerkingsalgoritmen.
Publiceren in het tijdschrift International Journal of Extreme Manufacturing , schreven het Nanoscale and Optical Metrology Research Center (NOMRC) onder leiding van prof. Shiyuan Liu en prof. Jinlong Zhu van de Huazhong University of Science and Technology en hun medewerkers van het Harbin Institute of Technology en de Chinese University of Hong Kong de eerste systematische review naar introduceer de onderzoeksachtergrond, bespreek de nieuwste voortgang en de trend van optische waferdefectinspectie. Deze review heeft onthuld dat geavanceerde technieken zoals nanofotonica, optische wervels, computationele beeldvorming, kwantitatieve fasebeeldvorming en diep leren een diepgaande invloed kunnen hebben op sub-10 nm defectinspectie. Het werk kan nieuwe wegen banen voor de inspectie van defecten in halfgeleiderwafels.
Prof. Jinlong Zhu en Prof. Shiyuan Liu zeggen dat "de steeds kleiner wordende kenmerken en ruimte op wafels met patronen de mogelijkheden van alle huidige metrologie- en inspectieoplossingen drastisch zouden belasten bij het balanceren van gevoeligheid, specificiteit, processnelheid en opnamesnelheid."
Optische far-field waferinspectie blijft een van de werkpaarden voor defectinspectie in de fab. In een conventioneel instrument voor het inspecteren van defecten worden de defecten vastgelegd door circuitpatroonafbeeldingen van aangrenzende matrijzen te vergelijken. De eerste auteur van het overzichtsartikel, prof. Jinlong Zhu, zegt dat "de sleutel tot defectinspectie niet de resolutie is, maar de signaal-ruisverhouding (SNR) en contrast. De verbetering van SNR en contrast is sterk afhankelijk van geavanceerde instrumenten, geavanceerde modelleringsarchitecturen en nabewerkingsalgoritmen, die ons er allemaal toe brachten een uitgebreide beoordeling te maken van waferdefectdetectiemethoden op basis van de volgende drie aspecten:(1) de evaluatie van de detecteerbaarheid van defecten, (2) de diverse optische inspectiesystemen, en (3 ) de nabewerkingsalgoritmen."
"Het is van groot belang om een beoordeling van de detecteerbaarheid van defecten uit te voeren voor een specifiek type inspectietools voor geavanceerde knooppunten", legt co-eerste auteur Dr. Jiamin Liu uit. "In feite omvat de evaluatie van de detecteerbaarheid van defecten meestal de formulering van kwantitatieve regels voor de SNR van de defectverstrooiingssignalen, de ontwikkeling van simulatietools voor het modelleren van defectverstrooiingssignalen en de analyse van defect-SNR. We ontdekten dat de defect-SNR aanzienlijk afhangt op materiaal- en defecttopologie."
De conventionele benaderingen bij optische defectinspectie, zoals de op amplitude gebaseerde benadering naast de nabewerkingsalgoritmen, zijn grondig besproken. De nieuwe inspectiemechanismen, waaronder fase-, orbitaal impulsmoment-, terahertz-golf- en hyperbolische Bloch-modi, zijn benadrukt om lezers te herinneren aan hun potentieel bij het openen van nieuwe richtingen in het veld. Bovendien is röntgen ptychografie, de enige optische methode die zowel oppervlakte- als onderoppervlakte sub-20 nm defecten voor de gehele wafer direct in beeld kan brengen, in het artikel ook in detail besproken en onderzocht. X-ray ptychografie heeft het potentieel om het veld te penetreren door revolutionaire 3D-resolutie en gevoeligheid te bieden zodra de nadelen, waaronder de synchrotron-röntgenlichtbron, een enorme hoeveelheid gegevens en de lage snelheid die in de toekomst worden overwonnen.
"Of het nu gaat om de eenvoudigste operator voor beeldverschil of het complexe synthetische beeldalgoritme of zelfs de deep learning-algoritmen, deze nabewerkingsalgoritmen spelen een cruciale rol bij de inspectie van optische defecten in termen van verbetering van de SNR en het contrast van defecten. Daarom hebben we een gedetailleerde bespreking van nabewerkingsalgoritmen die betrokken zijn bij de inspectie van waferdefecten met patronen, met een specifieke focus op de voor- en nadelen van deep learning-algoritmen," voegde co-eerste auteur Dr. Tianlai Xu verder toe.
Prof. Jinlong Zhu zegt dat ze "denken dat inspectie van optische defecten op wafels met patronen een uitdagend maar interessant onderwerp zal blijven dat dringend moet worden aangepakt. We geloven dat dit overzichtsartikel, dat is geschreven op basis van eerdere beoordelingen en enig verkennend onderzoek in de meest geavanceerde richting, is belangrijk voor zowel nieuwkomers in het veld als voor degenen die het willen gebruiken in interdisciplinair werk." + Verder verkennen
Invloed van vuile inspectievlakken op de nauwkeurigheid van visuele inspectie
 780, 000 geëvacueerd in India voorafgaand aan grote cycloon
780, 000 geëvacueerd in India voorafgaand aan grote cycloon Studie:opwarming maakt megadroogte in het westen van de VS de ergste in de moderne tijd
Studie:opwarming maakt megadroogte in het westen van de VS de ergste in de moderne tijd Geowetenschappers roepen op tot actie om raciale ongelijkheid in het veld aan te pakken
Geowetenschappers roepen op tot actie om raciale ongelijkheid in het veld aan te pakken Palcacocha-ijsvallen tonen kwetsbaarheden in Peru aan
Palcacocha-ijsvallen tonen kwetsbaarheden in Peru aan US West bereidt zich voor op mogelijke eerste verklaring van watertekort
US West bereidt zich voor op mogelijke eerste verklaring van watertekort
Hoofdlijnen
- Moleculaire mechanismen van paaigewoonten voor adaptieve straling van endemische Oost-Aziatische karperachtigen
- Bacteriën als pacemaker voor de darm
- De effectiviteit van camouflage bij verschillende dieren vergelijken
- Histologie maken Slides
- Wat zijn de vier eukaryotische koninkrijken?
- Onderzoekers fabriceren geminiaturiseerde bionische oceaanbatterij
- Zijn mannen of vrouwen betere navigators?
- Radiometrische datering: definitie, hoe werkt het, gebruik & voorbeelden
- Exotische dieren en de jacht op goud
- Een stippenpatroon verschijnt in supervloeibaar helium-3 in een dunne cel bij blootstelling aan een magnetisch veld
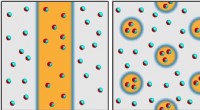
- Lasers activeren magnetisme in atomair dunne kwantummaterialen

- Ingenieurs kraken 58 jaar oude puzzel op weg naar kwantumdoorbraak

- Twee studies tonen de mogelijkheid aan dat er kosmische straling bestaat als gevolg van botsingen met donkere materie

- 3D-bioprinttechniek regelt de celoriëntatie

 Nieuwe studie onthult dat het centrum van de mariene biodiversiteit ter wereld in gevaar is
Nieuwe studie onthult dat het centrum van de mariene biodiversiteit ter wereld in gevaar is Supernova-explosies worden ondersteund door neutrino's van neutronensterren, een nieuwe waarneming suggereert:
Supernova-explosies worden ondersteund door neutrino's van neutronensterren, een nieuwe waarneming suggereert: Verstrengelde fotonen genereren met niet-lineaire meta-oppervlakken
Verstrengelde fotonen genereren met niet-lineaire meta-oppervlakken De eerste oppervlaktewateratlas in zijn soort brengt 35 jaar satellietgegevens samen
De eerste oppervlaktewateratlas in zijn soort brengt 35 jaar satellietgegevens samen Wind, Veranderingen in zee-ijs suggereren klimaatverandering in het westelijke deel van het noordpoolgebied
Wind, Veranderingen in zee-ijs suggereren klimaatverandering in het westelijke deel van het noordpoolgebied Wat is een stroomdiagram van kunststof?
Wat is een stroomdiagram van kunststof?  NASA ziet tropische storm 10S vormen langs de kust van West-Australië
NASA ziet tropische storm 10S vormen langs de kust van West-Australië Het draagvlak voor kunst en andere culturele objecten kan worden versterkt door hun collectieve waarde te benadrukken
Het draagvlak voor kunst en andere culturele objecten kan worden versterkt door hun collectieve waarde te benadrukken
- Elektronica
- Biologie
- Zonsverduistering
- Wiskunde
- French | Italian | Spanish | Portuguese | Swedish | German | Dutch | Danish | Norway |

-
Wetenschap © https://nl.scienceaq.com

