
Wetenschap
Team ontwikkelt gevoelige nieuwe manier om transistordefecten te detecteren
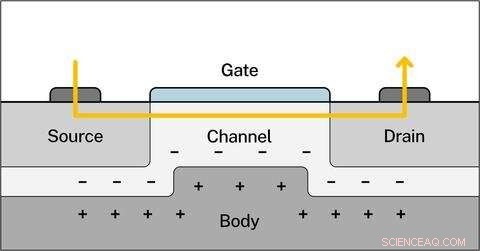
Tijdens de normale werking van de transistor, een geleidend kanaal (gecontroleerd door de poort) vormt zich tussen de bron en de afvoer, een stroom laten vloeien. Krediet:Sean Kelley/NIST
Onderzoekers van het National Institute of Standards and Technology (NIST) en medewerkers hebben een nieuwe, zeer gevoelige methode voor het detecteren en tellen van defecten in transistors - een zaak van dringende zorg voor de halfgeleiderindustrie, aangezien deze nieuwe materialen ontwikkelt voor apparaten van de volgende generatie. Deze defecten beperken de prestaties van de transistor en het circuit en kunnen de betrouwbaarheid van het product beïnvloeden.
Een typische transistor is, voor de meeste toepassingen, eigenlijk een schakelaar. Als het aan is, stroom vloeit van de ene kant van een halfgeleider naar de andere; uitzetten stopt de stroom. Die acties creëren respectievelijk de binaire enen en nullen van digitale informatie.
De prestaties van de transistor hangen in grote mate af van hoe betrouwbaar een bepaalde hoeveelheid stroom zal vloeien. Defecten in het transistormateriaal, zoals ongewenste "onzuiverheids"-gebieden of verbroken chemische bindingen, de stroom onderbreken en destabiliseren. Deze defecten kunnen zich onmiddellijk of gedurende een langere periode manifesteren terwijl het apparaat in bedrijf is.
Over vele jaren, wetenschappers hebben talloze manieren gevonden om die effecten te classificeren en te minimaliseren.
Maar defecten worden moeilijker te identificeren omdat de afmetingen van de transistor bijna onvoorstelbaar klein worden en de schakelsnelheden erg hoog. Voor enkele veelbelovende halfgeleidermaterialen in ontwikkeling, zoals siliciumcarbide (SiC) in plaats van alleen silicium (Si) voor nieuwe hoogenergetische, apparaten voor hoge temperaturen - er is geen eenvoudige en duidelijke manier om defecten in detail te karakteriseren.
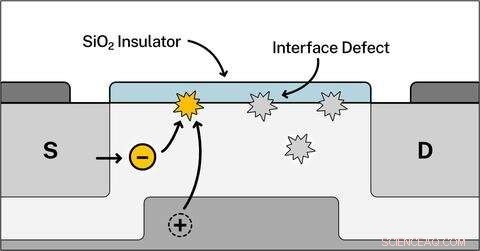
Echter, elektronen die van de bron naar de afvoer gaan, kunnen defecten tegenkomen die leiden tot recombinatie met een gat, wat resulteert in een verlies van stroom en het maken van de transistor onbetrouwbaar. De belangrijkste hiervan worden interfacedefecten genoemd, bestaande op het grensvlak tussen de siliciumoxide- en siliciumlagen. Krediet:Sean Kelley/NIST
"De door ons ontwikkelde methode werkt met zowel traditioneel Si als SiC, waardoor we voor het eerst niet alleen het type defect kunnen identificeren, maar ook het aantal ervan in een bepaalde ruimte met een eenvoudige DC-meting, " zei James Ashton van NIST, die het onderzoek uitvoerde met collega's van NIST en Pennsylvania State University. Ze publiceerden hun resultaten op 6 oktober in de Tijdschrift voor Toegepaste Natuurkunde . Het onderzoek richt zich op interacties tussen de twee soorten elektrische ladingsdragers in een transistor:negatief geladen elektronen en positief geladen "gaten, ", dit zijn ruimtes waar een elektron ontbreekt in de lokale atomaire structuur.

Om deze gebreken te tellen, onderzoekers plaatsen de transistor in de "bipolaire versterking" -modus door een spanning op de source en gate aan te brengen. Dit zorgt voor een afnemende concentratie van elektronen over het kanaal. In deze configuratie, de stroom van de bron naar de afvoer is zeer gevoelig voor interface-defecten. Krediet:Sean Kelley/NIST
Wanneer een transistor correct functioneert, een specifieke elektronenstroom vloeit langs het gewenste pad. (Gaten kunnen ook een stroom vormen. Dit onderzoek onderzocht elektronenstroom, de meest voorkomende regeling.) Als de stroom een defect tegenkomt, elektronen worden gevangen of verplaatst, en kan vervolgens worden gecombineerd met gaten om een elektrisch neutraal gebied te vormen in een proces dat bekend staat als recombinatie.
Elke recombinatie verwijdert een elektron uit de stroom. Meerdere defecten veroorzaken stroomverliezen die tot storingen leiden. Het doel is om te bepalen waar de gebreken zitten, hun specifieke effecten, en - idealiter - het aantal ervan.
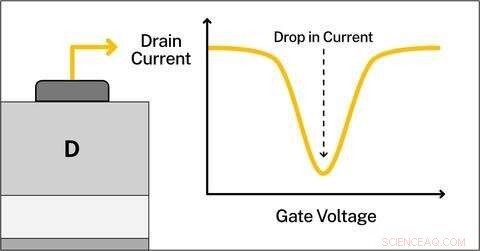
Door de stroom bij de afvoer te bewaken terwijl de poortspanning wordt gevarieerd, onderzoekers kunnen het aantal defecten nauwkeurig bepalen door de stroomdaling. Krediet:Sean Kelley/NIST
"We wilden fabrikanten een manier bieden om defecten te identificeren en te kwantificeren terwijl ze verschillende nieuwe materialen testen, "Zei NIST-co-auteur Jason Ryan. "We hebben dat gedaan door een natuurkundig model te maken van een defectdetectietechniek die veel wordt gebruikt maar tot nu toe slecht wordt begrepen. Vervolgens voerden we proof-of-principle-experimenten uit die ons model bevestigden."
In een klassiek metaaloxide-halfgeleiderontwerp (zie afbeelding), een metalen elektrode, de poort genaamd, wordt bovenop een dunne isolerende laag siliciumdioxide geplaatst. Onder die interface bevindt zich het bulklichaam van de halfgeleider.
Aan de ene kant van de poort bevindt zich een ingangsklem, de bron genoemd; aan de andere kant is een uitgang (afvoer). Wetenschappers onderzoeken de dynamiek van de stroom door de "bias" -spanningen die op de poort worden toegepast te veranderen, bron en afvoer, die allemaal van invloed zijn op hoe de stroom beweegt.
In het nieuwe werk de NIST- en Penn State-onderzoekers concentreerden zich op één bepaalde regio die doorgaans slechts ongeveer 1 miljardste van een meter dik en een miljoenste van een meter lang is:de grens, of kanaal, tussen de dunne oxidelaag en het bulkhalfgeleiderlichaam.
"Deze laag is enorm belangrijk omdat het effect van een spanning op het metaal boven het oxide van de transistor werkt om te veranderen hoeveel elektronen zich in het kanaalgebied onder het oxide bevinden; dit gebied regelt de weerstand van het apparaat van bron tot afvoer, Ashton zei. "De prestaties van deze laag zijn afhankelijk van het aantal defecten. Met de door ons onderzochte detectiemethode kon voorheen niet worden vastgesteld hoeveel defecten zich binnen deze laag bevonden."
Een gevoelige methode om defecten in het kanaal te detecteren, wordt elektrisch gedetecteerde magnetische resonantie (EDMR) genoemd. wat in principe vergelijkbaar is met medische MRI. Deeltjes zoals protonen en elektronen hebben een kwantumeigenschap genaamd spin, waardoor ze zich gedragen als kleine staafmagneten met twee tegenovergestelde magnetische polen. In EDMR, de transistor wordt bestraald met microgolven met een frequentie die ongeveer vier keer hoger is dan die van een magnetron. Onderzoekers passen een magnetisch veld toe op het apparaat en variëren geleidelijk de sterkte terwijl ze de uitgangsstroom meten.
Bij precies de juiste combinatie van frequentie en veldsterkte, elektronen bij defecten "draaien" - hun polen omkeren. Dit zorgt ervoor dat sommigen genoeg energie verliezen om te recombineren met gaten bij defecten in het kanaal, het verminderen van de stroom. De kanaalactiviteit kan moeilijk te meten zijn, echter, vanwege het hoge volume van "ruis" van recombinatie in het grootste deel van de halfgeleider.
Om uitsluitend te focussen op activiteit in het kanaal, onderzoekers gebruiken een techniek die bipolair amplificatie-effect (BAE) wordt genoemd, die wordt bereikt door de voorspanningen die op de bron worden toegepast, te rangschikken, poort en afvoer in een bepaalde configuratie (zie afbeelding). "Dus vanwege de bias die we gebruiken in BAE en omdat we de huidige niveaus bij de afvoer meten, "Ashton zei, "we kunnen interferentie elimineren van andere dingen die in de transistor gebeuren. We kunnen alleen defecten selecteren waar we om geven binnen het kanaal."
Het exacte mechanisme waarmee BAE werkt, was niet bekend totdat het team zijn model ontwikkelde. "De enige meetresultaten waren kwalitatief, dat wil zeggen, ze konden de soorten defecten in het kanaal vertellen, maar niet het aantal, " zei co-auteur Patrick Lenahan, een vooraanstaande professor in de technische wetenschappen en mechanica aan Penn State.
Vóór het model van BAE, het schema werd uitsluitend gebruikt als hulpmiddel voor het toepassen van spanningen en het regelen van stromen voor EDMR-metingen, wat nuttig is voor een meer kwalitatieve identificatie van defecten. Het nieuwe model stelt BAE als hulpmiddel in staat om het aantal defecten kwantitatief te meten en dit te doen met alleen stromen en spanningen. De parameter van belang is de dichtheid van de interfacedefecten, dat is een getal dat beschrijft hoeveel defecten zich binnen een bepaald gebied van het halfgeleider-oxide-interface bevinden. Het BAE-model geeft onderzoekers een wiskundige beschrijving van hoe de BAE-stroom is gerelateerd aan de defectdichtheid.
Het model, die de onderzoekers testten in een reeks proof-of-concept-experimenten op metaaloxide-halfgeleidertransistors, maakt kwantitatieve metingen mogelijk. "Nu kunnen we rekening houden met de variatie in de distributie van ladingdragers in het kanaalgebied, Ashton zei. "Dit opent de mogelijkheden van wat kan worden gemeten met een eenvoudige elektrische meting."
"Deze techniek kan een uniek inzicht verschaffen in de aanwezigheid van deze destabiliserende transistordefecten en een pad naar mechanistisch begrip van hun vorming, " zei Markus Kuhn, voorheen bij Intel en nu senior directeur van halfgeleidermetrologie en fellow bij Rigaku, die niet bij het onderzoek betrokken was. "Met zo'n kennis, er zou een grotere kans zijn om ze te beheersen en te verminderen om de prestaties en betrouwbaarheid van de transistor te verbeteren. Dit zou een kans zijn om het ontwerp van de chipcircuits en de apparaatprestaties verder te verbeteren, wat leidt tot beter presterende producten."
Dit verhaal is opnieuw gepubliceerd met dank aan NIST. Lees hier het originele verhaal.
 Moleculaire schatkaarten om nieuwe materialen te ontdekken
Moleculaire schatkaarten om nieuwe materialen te ontdekken 3D-katalysatoren voor verbeterde hydrazinevrije drijfgassen
3D-katalysatoren voor verbeterde hydrazinevrije drijfgassen Wetenschappers maken een atomair lijmpistool om betere nucleïnezuurtherapieën te bouwen
Wetenschappers maken een atomair lijmpistool om betere nucleïnezuurtherapieën te bouwen Een nieuwe strategie voor de biosynthese van natuurlijke producten
Een nieuwe strategie voor de biosynthese van natuurlijke producten De bizarre wereld van topologische materialen
De bizarre wereld van topologische materialen
 Bij het berekenen van de maatschappelijke kosten van methaan, gelijkheid is van belang
Bij het berekenen van de maatschappelijke kosten van methaan, gelijkheid is van belang Een toekomst voorstellen waarin alle bomen in Europa verdwijnen
Een toekomst voorstellen waarin alle bomen in Europa verdwijnen Toenemende resolutie van gegevens over de temperatuur van het zeeoppervlak veroorzaakt kunstmatige decadale variabiliteit van stormtrack
Toenemende resolutie van gegevens over de temperatuur van het zeeoppervlak veroorzaakt kunstmatige decadale variabiliteit van stormtrack Ecologieteam ontdekt dat bladafval langzamer afbreekt bij warme temperaturen
Ecologieteam ontdekt dat bladafval langzamer afbreekt bij warme temperaturen Californië zal naar verwachting deze eeuw natter worden
Californië zal naar verwachting deze eeuw natter worden
Hoofdlijnen
- Giftige Death Cap-paddenstoel verspreidt zich over Noord-Amerika
- Wat wordt er weergegeven als geen enkele kopie van een allel de expressie maskeert?
- Onderzoekers onthullen het mechanisme waarmee cellulaire kernen hun positie in spiercellen bereiken
- Hoe een 3D-model van een plantencel te maken
- Soorten redeneren in geometrie
- Deze 8 foto's van puppy's kunnen je helpen focussen,
- Hoe werkt ureum denatureiwitten?
- Wat is de complementaire basispaarregel?
- Rangorde gebruiken om complexe genetische interacties te identificeren
- Glasmoleculen kunnen werken als zand wanneer ze vastlopen, studie vondsten

- Studie maakt het voorspellen van rekenkracht van vroege kwantumcomputers mogelijk

- Motor met een diameter van vijf millimeter wordt direct aangedreven door licht

- Einstein-de Haas-effect biedt nieuw inzicht in een raadselachtig magnetisch fenomeen

- Nanostructuren maken een recordopwekking van hoge harmonische mogelijk

 Waarom kleine microben een grote factor kunnen zijn in hoe klimaatverandering zich ontvouwt
Waarom kleine microben een grote factor kunnen zijn in hoe klimaatverandering zich ontvouwt Warmtetransport kan effectiever worden geblokkeerd met een meer geoptimaliseerde nanostructuur met gaten
Warmtetransport kan effectiever worden geblokkeerd met een meer geoptimaliseerde nanostructuur met gaten Breuken schrijven in Words
Breuken schrijven in Words Het Falcon Lake-incident
Het Falcon Lake-incident  Hoe BTU naar MCF
Hoe BTU naar MCF Cephalization of Earthworms
Cephalization of Earthworms  Historisch onderzoek vindt dat het aanpakken van ongelijkheid de sleutel is tot het realiseren van VN-doelen
Historisch onderzoek vindt dat het aanpakken van ongelijkheid de sleutel is tot het realiseren van VN-doelen Wat orkaancategorieën echt betekenen
Wat orkaancategorieën echt betekenen
- Elektronica
- Biologie
- Zonsverduistering
- Wiskunde
- French | Italian | Spanish | Portuguese | Swedish | German | Dutch | Danish | Norway |

-
Wetenschap © https://nl.scienceaq.com

